「多層基板」の製造工程をご紹介します。
内層、外層の各材料を規定のパネル寸法に切断します。

1.両面にドライフィルム(エッチングレジスト)をラミネートします。
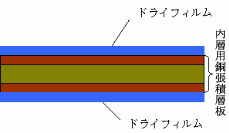

2.内層パターンを焼付けします。


3.パターン以外の不要部分を除去しパターン形成用レジストが完成します。

4.エッチング工程でパターン以外の部分の銅箔を除去します。

5.エッチング工程後残ったレジストを剥離します。

パターン形成済みの内層基板と外層用銅張積層板をプリプレグを用いて接着します。


スルーホール、VIA(ビアホール)、取り付け穴などの穴あけ加工を行います。
(NCドリルデータをもとに穴あけ加工を行います)


外層と内層の銅箔面を電気的に接続するために、スルーホールメッキによって貫通穴の内部の銅メッキを行います。


1.両面にドライフィルム(エッチングレジスト)をラミネートします。


2.パターンを焼付けします。(このとき穴加工した部分は塞いでおきます)


3.パターン以外の不要部分を除去しパターン形成用レジストが完成します。

4.エッチング工程でパターン以外の部分の銅箔を除去します。

5.エッチング工程後残ったレジストを剥離します。


パターン形成後パターン間の絶縁と半田付け工程で余計な部分に半田を付着させないためにソルダーレジストを形成します。
1.カーテンコート方式でレジスト液を塗布します。(乾燥)
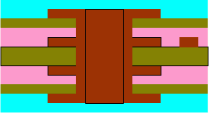

2.レジストパターンを焼付けします。(乾燥硬化)


3.未硬化部分を除去しレジストが形成されます。

パターン露出部に半田付け性の向上や銅箔部の防錆を目的に、半田メッキ(有鉛、無鉛)、無電解金メッキ、水溶性フラックス処理などの表面処理を行います。


プリント基板への部品実装時にガイドの役割をするシンボルマークをシルク印刷します。

外形及びプリント基板内の開口部などを加工します。


フライングチェッカにて断線、ショートのチェックを全数確認いたします。
(HIOKI社製)

Copyright©2025 SystemgerDirect システムギアダイレクト









